Wire Bonding is a primary internal interconnect method used as an internal interconnect to the actual die surface or the first stage of the device logic. This connection takes the logic signal or the chip's telecommunications. The number is connected to the outside world. Other primary interconnect methods include flip chip and tape automated soldering (TAB), but ultrasonic bonding has an absolute advantage in these methods of connection, with more than 90% of all interconnects using this method. In this figure, about 90% use gold wire ultrasonic welding, and the rest use aluminum and other precious metals or materials similar to precious metals.
Ultrasonic bonding is used for chip-to-substrate, substrate-to-substrate or substrate-to-package connections. It comes in two forms: ball and wedge. Gold wire ball bonding is the most common method. In this process, a molten gold ball sticks to a line, after pressing it as the first solder joint, then draws the curved line from the first solder joint and then new. The moon shape connects the line (the second wedge solder joint) and then forms another new ball for the next first ball joint. Gold ball bonding is classified as a thermoacoustic process, which means that the solder joints are formed by a combination of heat (typically 150), ultrasonic waves, pressure and time. °C
The second method of pressure welding is a wedge process. This process mainly uses aluminum wire, but it can also be used with gold wire, usually at room temperature. Wedge welding presses two wedge-shaped solder joints to form a joint, and no ball is formed in this process. The aluminum wire welding process is classified as ultrasonic wire bonding, and only the ultrasonic energy, pressure, and time parameters are used to form the solder joint.
The use of different process types depends on the specific application. For example, gold wire pressure welding is used in mass production because the process speed is faster. Aluminum wire bonding is used for packaging or where the PCB cannot be heated. In addition, the wedge bonding process has a finer pitch than the gold wire bonding. At present, the pitch limit of gold wire bonding is 60 μm; the pitch of less than 60 μm can be achieved by thin aluminum wire wedge welding.
Wire bond
Wire bonding first fixes the chip on a suitable substrate or lead frame, and then connects the circuit on the chip to the circuit on the substrate or lead frame with a thin metal wire as shown.
The method of connection usually uses hot pressing, ultrasonic, or a combination of both. The diameter of the metal wires used in this technique is usually between 25 and 75 μm. The metal wire is mainly made of aluminum and gold, and the copper wire is being evaluated for the possibility of replacing the gold wire. The die is fixed on the substrate and the lead frame (Die Bond), mainly using a polymer adhesive, a solder solder, and a eutectic alloy. The choice of chip fixing materials is mainly determined by the airtightness requirements of the package, heat dissipation capability, and thermal expansion coefficient. Gold-silicon, gold-tin eutectic alloy, and silver-filled epoxy resin adhesive. Because of the simplicity of the wire bonding technology and the ease of application in the new process, coupled with the long-term development of all the technologies and tools, the recent advances in automation and wire bonding speed have made great progress. Wire bonding is still the main technology on the market today. 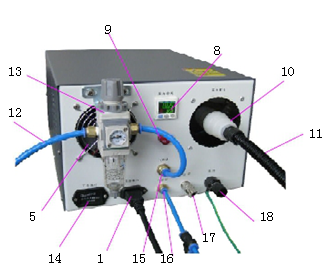
Samsung Ceramic Chip Capacitors
Samsung Capacitor,Samsung Chip Capacitors,Original Samsung Capacitor,Samsung Ceramic Chip Capacitors
JINGGANGSHAN MEICHENG ELECTRONIC TRADING CO.,LTD , http://www.meicheng-tra.com